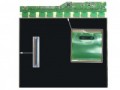
Aplikace v opravách BGA
Položek na stránku

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Tepelná komprese
Spojování pomocí tepelné komprese je možno použít k připojování drátu nebo lícního čipu. K tomu jsou zapotřebí kontakty z tažných materiálů, např. nálitky s výstupkem, vytvořené ze zlatých drátů.

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka BGA / CSP
Velké kuličkové matice (BGA) a matice s malou roztečí (CSP) vyžadují konfigurace, kombinující přesnou regulaci teploty a optiku s vysokým rozlišením, aby byl zajištěn proces předělávky bez pórů a přesné vyrovnání.

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka stíněných SMD
Protože stále trvá velká poptávka po deskách PS, konstrukce s vysokofrekvenčním stíněním zůstane při předělávkách problémem.

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka konektorů SMD
Vzhledem k požadavkům na omezený prostor, miniaturní konektory SMD se stále častěji používají u sestav s malými součástkami, kupříkladu v mobilních přístrojích.

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka QFN
Plochá pouzdra, jako jsou QFN (čtvercová bezvývodová pouzdra s malou roztečí) nebo MLF (rámečky s mikro vývody) s vynikajícími tepelnými, indukčními a kapacitními vlastnostmi (výsledkem čeho jsou kupříkladu podstatně kratší reakční doby) jsou stále častěji začleňovány do hustě osazených sestav, šetřících prostor.

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka 01005
Malé pasivní součástky 01005 (a 03015) v poslední době nabývají na důležitosti (integrace, miniaturizace atd.).

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka pouzdra na pouzdru (PoP)
Pouzdro na pouzdru (PoP) je technologie zapouzdření integrovaného obvodu se svisle kombinovanými logickými a paměťovými prvky, kde jsou na sobě umístěny dva nebo několik pouzder BGA (kuličkové vývody v šachovnicovém uspořádání).

Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka prvku se spodní výplní
Součástky se spodní výplní [underfilled components] se používají ve výrobcích spotřební elektroniky (mobilní přístroje, přenosné počítače atd.), v automobilovém průmyslu (snímací moduly, ovládací jednotky motoru atd.) nebo tam, kde jsou lícní čipy začleněny do výrobků s maximální miniaturizací.
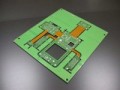
Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka čipu na ohebném substrátu
Ohebné substráty se používají v třírozměrných spojovacích a mechatronických koncepcích 3D ke snížení počtu potřebných konektorů. Ty snesou mnoho dynamických ohybů a jsou schopny vytvářet rychlé spoje mezi různými obvodovými vrstvami. V přenosných aplikacích je možno zajistit maximální miniaturizaci skládáním DPS.
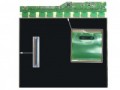
Datum: 16.04.2014
|
Kategorie: Aplikace v opravách BGA
Předělávka lícního čipu je nová oblast, jejíž důležitost se stále zvyšuje ve snaze spořit na nákladech recyklováním cenných materiálů. Typické aplikace lícního čipu najdeme v technologii displejů TFT, používaných pro LCD, plazmu, e-ink, OLED nebo 3D.







